高密度探針卡量測,為何必須走向 3D 輪廓分析?
隨著半導體測試腳位數提升與 pitch 持續縮小,高密度探針卡(垂直式探針卡 Vertical Probe Card / 微機電探針卡 MEMS Probe Card)的幾何一致性,已直接影響接觸穩定度與測試良率。針尖高度分佈、局部翹曲或系統性偏移,若無法被完整掌握,往往在量產後才浮現問題。
傳統工具顯微鏡以「局部、抽樣、人工判讀」為核心,在高密度情境下逐漸暴露三大限制:
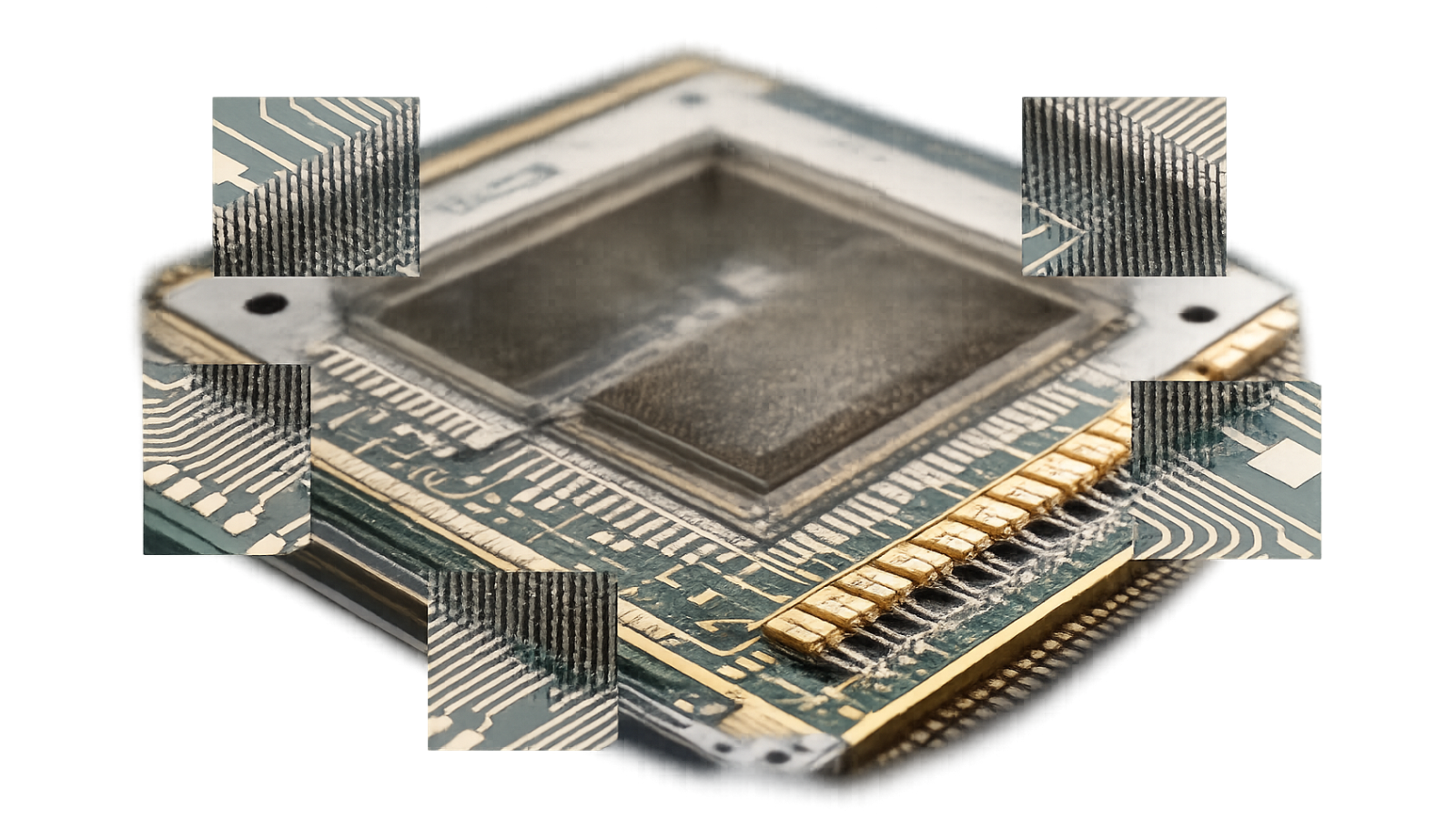
拼湊的視野,難窺全貌
2. 抽樣風險高,容易錯過區域性或群組性異常

抽樣的賭注,錯失群組性異常
3. 結果高度依賴操作者經驗,缺乏可追溯、可比較的工程數據
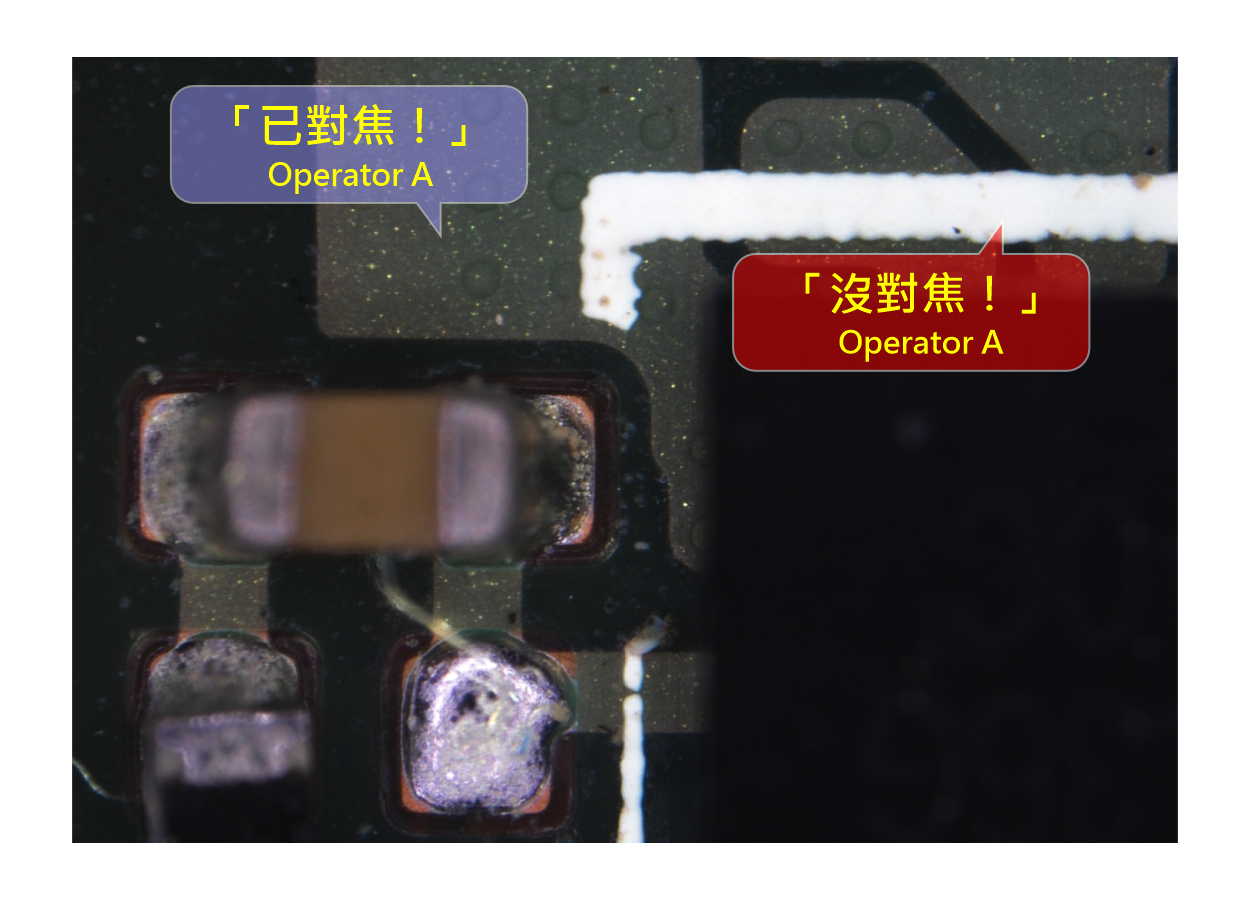
依賴經驗,缺乏可以比較的數據經驗
工程現場真正需要的,早已不是「量得到某一點」,而是「判讀整體結構是否一致」。在高密度結構中,測試穩定度更取決於同層針尖的相對高度關係與分佈趨勢,而非單點的絕對數值。若只依賴局部量測,反而容易將整體姿態誤判為個別缺陷。
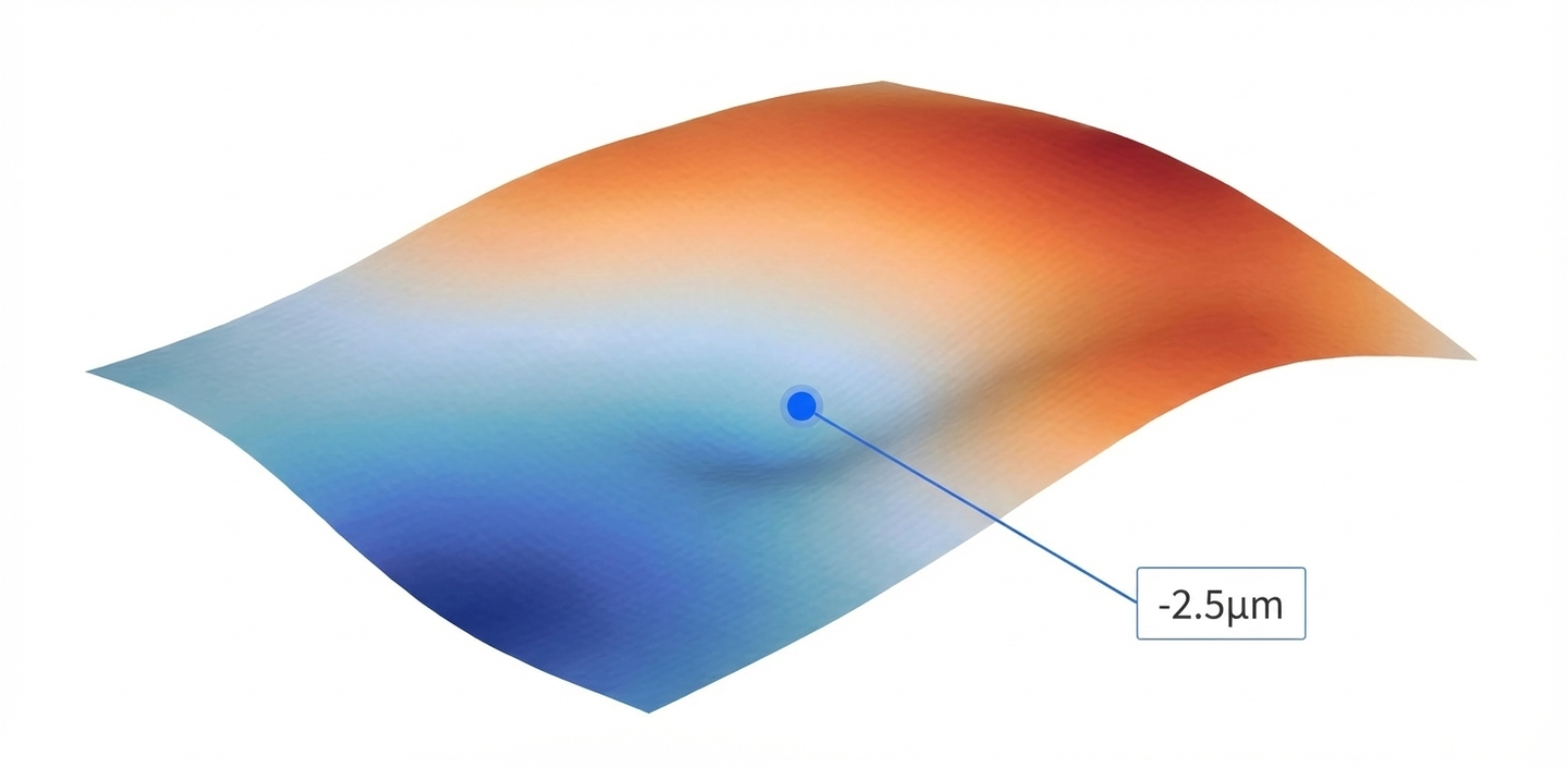
穩定度取決於相對高度關係與分布趨勢,而非單點的絕對數值
3D 輪廓量測正是在此背景下成為關鍵技術。透過完整的高度分佈資料,可將全區結構納入同一基準進行比較,讓工程判讀從經驗導向,轉為數據導向。
